
|
Опрос
|
реклама
Быстрый переход
TSMC начала оснащать свою крупнейшую фабрику по упаковке чипов — это снизит дефицит ИИ-чипов Nvidia
02.04.2025 [14:01],
Алексей Разин
Дефицит мощностей по упаковке чипов методом CoWoS вынуждает TSMC стремительно их наращивать, в этом году она собирается удвоить производительность в этой сфере, и уже приступила к оснащению оборудованием своего крупнейшего предприятия AP8 данного профиля, которое было куплено у производителя дисплеев Innolux в прошлом году. 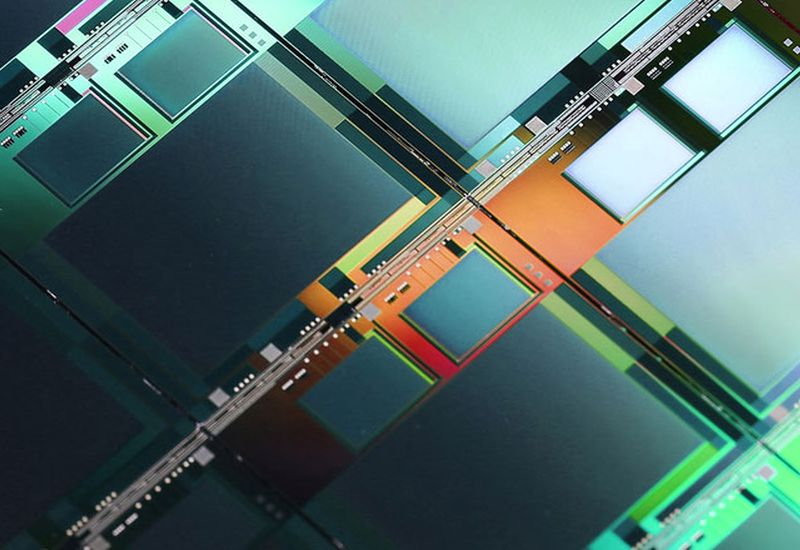
Источник изображения: TSMC Специфика производства ЖК-панелей и упаковки чипов в чём-то перекликается, поэтому TSMC и получила возможность в сжатые сроки и с минимальными затратами переоборудовать предприятие Innolux под свои нужды. Фабрика на юге Тайваня располагает чистыми комнатами совокупной площадью 100 000 м², и по этому критерию является крупнейшей на балансе TSMC. Например, уже действующее предприятие AP5 в четыре раза меньше нового. Соответственно, после введения AP8 в строй в течение ближайших нескольких месяцев TSMC существенно увеличит свои мощности по упаковке чипов методом CoWoS. Предполагается, что AP8 начнёт работать через шесть месяцев, тем самым значительно способствуя сокращению дефицита чипов Nvidia для ускорителей вычислений, которые выпускаются с использованием метода CoWoS. Специалисты TSMC обрели огромный опыт в установке и настройке соответствующего оборудования, поэтому затраты времени на его запуск на конкретной производственной площадке могут сократиться относительно типичных шести месяцев. По прогнозам экспертов, темпы экспансии мощностей по упаковке чипов методом CoWoS в этом году вырастут до 124,3 % по сравнению с прошлогодними 105,6 %, но в следующем году они снизятся до 34,9 %. Скажется не только насыщение рынка, но и начавшаяся миграция на прочие методы упаковки чипов. Помимо SoIC и CoPoS, компания TSMC будет предлагать клиентам SoW и WMCM. Технически Intel готова упаковывать чипы для клиентов TSMC
31.03.2025 [04:59],
Алексей Разин
Спрос на ускорители вычислений Nvidia растёт опережающими темпами, и одной из причин непропорционального увеличения предложения являются проблемы с упаковкой чипов на мощностях TSMC. Представители Intel утверждают, что решения клиентов TSMC с упаковкой типа CoWoS можно без проблем перенести на фирменную технологию Foveros. 
Источник изображения: Intel Об этом в переписке с группой репортёров, как сообщает EE Times, заявил недавно Марк Гарднер (Mark Gardner), вице-президент Intel Foundry по упаковке и тестированию: «Что касается Foveros, то она способна обеспечить бесшовный переход. Мы взяли продукты, которые используют технологию CoWoS, и прямым образом портировали их без каких-либо изменений в дизайне на технологию Foveros». Если учесть, что чипы для ускорителей вычислений Nvidia используют технологию упаковки CoWoS, есть вероятность их успешного переноса на конвейер Intel Foundry — хотя бы на стадии упаковки и тестирования. Важно, что тем самым Nvidia быстрее исключит транспортировку кремниевых пластин на Тайвань при условии их предварительной обработки в США на предприятии TSMC в Аризоне. То есть, политические факторы могут сыграть Intel на руку сильнее, чем технологические или экономические. По словам представителя Intel, компания с прошлого года выпускает решения, которые изначально разрабатывались под CoWoS, но позже были приспособлены под фирменные технологии EMIB или Foveros. Для потенциальных клиентов это важно, как добавил Гарднер, поскольку это не вынуждает их долго ждать адаптации дизайна своих компонентов под возможности нового подрядчика. Внутри Intel есть команда специалистов, которые взаимодействуют с TSMC, Samsung, SK hynix и Micron в вопросах унификации правил дизайна, позволяющих использовать интерфейсы в сложной пространственной компоновке чипов с минимальными изменениями при переносе с одного конвейера на другой. Как признался Гарднер, компания Intel разработала технологию упаковки EMIB-T с использованием межслойных соединений, которая позволяет создавать чипы с трёхмерной компоновкой и высокой пропускной способностью интерфейсов без высокого энергопотребления. Клиенты Intel уже готовы использовать эту технологию в последующие год или два. Впрочем, имена своих клиентов контрактное подразделение Intel до сих пор раскрывает неохотно, и в конкретной беседе с представителями EE Times упоминались только Mediatek и AWS (Amazon). Эксперты TechInsights утверждают, что Intel не особо продвигает свои возможности по контрактной упаковке чипов, тогда как компания располагает не только передовыми технологиями в этой сфере, но и свободными производственными мощностями. Траектория развития полупроводниковой отрасли такова, что на нынешнем этапе упаковке важно уделять внимание, поскольку она позволяет эффективно повышать производительность компонентов без видимого прогресса в литографии. Заказы Nvidia займут до 70 % всех мощностей TSMC по упаковке чипов методом CoWoS-L в этом году
24.02.2025 [07:46],
Алексей Разин
Независимые аналитики уже отмечали, что заказы на изготовление чипов для ускорителей Nvidia в этом году потребуют использования 77 % всех доступных кремниевых пластин соответствующего класса. Тайваньские источники теперь добавляют, что эти же заказы загрузят около 70 % мощностей по тестированию и упаковке чипов с использованием передового метода CoWoS-L. 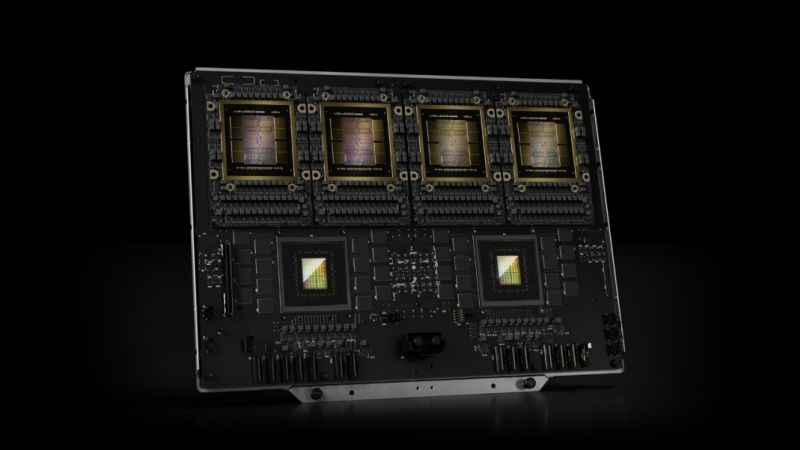
Источник изображения: Nvidia Данная технология упаковки требуется для производства чипов поколения Blackwell, лежащих в основе передовых ускорителей вычислений Nvidia, как напоминает Economic Daily News. В течение этого года TSMC будет ежеквартально увеличивать мощности по упаковке чипов этим методом на 20 % как минимум, что позволит по итогам года в целом выйти на обработку более 2 млн изделий такого типа. Кроме того, дополнительный спрос могут создать заказы со стороны участников инициативы Stargate в США, поскольку для развития национальной вычислительной структуры в этой стране тоже потребуется приличное количество ускорителей Nvidia. Если в прошлом году услуги по упаковке чипов с использованием передовых методов обеспечивали 8 % всей выручки TSMC, то в этом они перевалят за 10 %, по мнению руководства компании. Экспансия производства ускорителей поколения Blackwell постепенно снизит потребность в представителях семейства Hopper (H100/H200), и новое поколение начнёт доминировать уже во втором полугодии. В ближайшее время, как сообщается, TSMC приложит усилия к расширению восьми своих предприятий по упаковке чипов методом CoWoS. Среди них имеются и два предприятия, купленных у Innolux, на которых ранее выпускались панели для дисплеев. Кроме того, TSMC пока не определилась с местом строительства двух новых предприятий такого профиля. Как не устаёт отмечать руководство TSMC, даже существующие темпы расширения мощностей по упаковке чипов не позволяют покрыть имеющийся спрос на данные услуги. С конца прошлого года до конца следующего TSMC планирует увеличить мощности по упаковке чипов в три раза. Nvidia переведёт чипы Blackwell на улучшенную упаковку CoWoS-L — это сулит трудности для компании и партнёров
16.01.2025 [15:02],
Алексей Разин
Уже второй год подряд посещая Китай и Тайвань в канун Нового года по китайскому лунному календарю, основатель и бессменный руководитель Nvidia Дженсен Хуанг (Jensen Huang) пояснил, что для производства передовых ускорителей вычислений семейства Blackwell будет востребована технология упаковки CoWoS-L, а от устаревающей CoWoS-S компания будет постепенно отходить. Возможно, такая миграция создаст определённые трудности в работе как самой Nvidia, так и её партнёров. 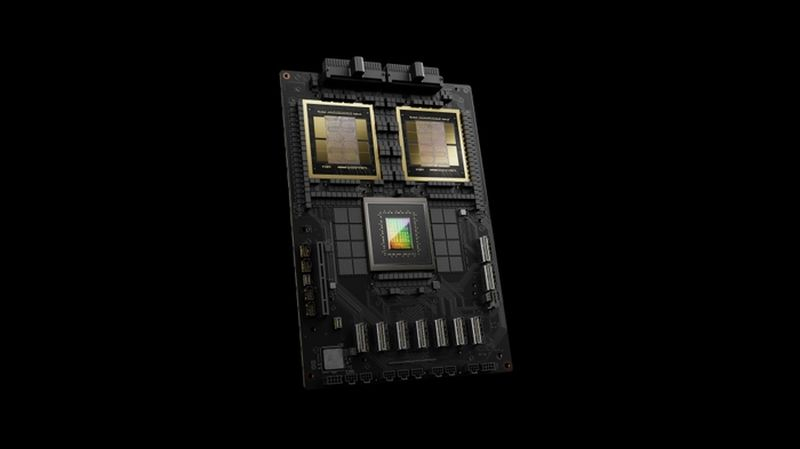
Источник изображения: Nvidia Как отмечает Reuters, глава Nvidia сделал следующие пояснения: «По мере перехода на Blackwell, мы будем в основном использовать CoWoS-L. Конечно, мы всё ещё производим Hopper, который будет использовать CoWoS-S. Мы также будем переводить связанные с CoWoS-S мощности на использование CoWoS-L». По сути, главным преимуществом CoWoS-L является возможность объединить несколько кристаллов на одной подложке специальным высокоскоростным интерфейсом, и такая компоновка очень востребована в сегменте ускорителей вычислений. Другими словами, как добавил Хуанг, речь идёт не о снижении объёмов упаковки чипов в целом, а о переходе с CoWoS-S на CoWoS-L. В любом случае, как признался глава Nvidia, сейчас компании и её партнёрам доступно в четыре раза больше мощностей по упаковке чипов, чем пару лет назад. По данным известных отраслевых аналитиков, Nvidia недавно пересмотрела свои перспективные производственные планы, отдав приоритет использованию упаковки CoWoS-L, которая применяется в сочетании с многокристальной упаковкой. Соответственно, однокристальные версии ускорителей семейства Blackwell были сняты с производства, и теперь все силы брошены на увеличение объёмов выпуска многокристальных версий, которым нужна упаковка CoWoS-L. Компания TSMC в этом контексте пострадает не так сильно, а вот некоторые поставщики обеих компаний окажутся в затруднительном положении из-за срочной перестройки цепочек поставок и производства. TSMC к 2026 году утроит мощности по упаковке чипов методом CoWoS, чтобы лучше обслуживать Nvidia
15.12.2024 [08:19],
Алексей Разин
Бурный рост выручки Nvidia на фоне высокого спроса на её ускорители вычислений в действительности сдерживается возможностями её производственных партнёров, главным из которых является TSMC. Последняя не только выпускает чипы для Nvidia, но и упаковывает их передовым методом CoWoS, и возможности подрядчика в этой сфере являются для Nvidia узким местом, которое он готов активно расширять. 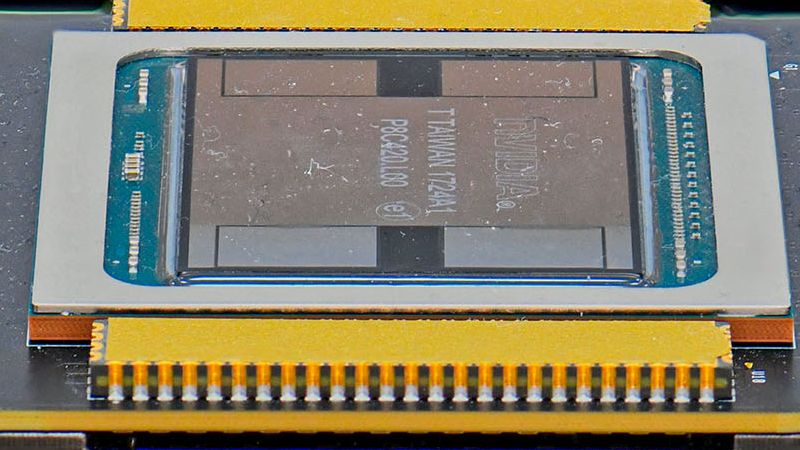
Источник изображения: TSMC По информации Commercial Times, компания TSMC интенсивно расширяет на территории Тайваня свои производственные мощности по тестированию и упаковке чипов методом CoWoS. Купленное у Innolux предприятие по производству ЖК-панелей в Тайнане будет переоборудовано под тестирование и упаковку чипов к концу следующего года, и совокупные возможности TSMC в этой сфере к концу 2026 года утроятся до 90 000 кремниевых пластин в месяц, по данным тайваньских источников. Профильное предприятие TSMC в Тайчжуне будет введено в строй в первой половине следующего года, компания также строит два предприятия в других районах острова. В текущем году, по оценкам аналитиков, TSMC была способна упаковывать и тестировать чипы с использованием метода CoWoS в количестве, эквивалентном 35 000 кремниевых пластин в месяц. Выручка от данного вида услуг достигла 7–9 % от совокупной. К концу следующего года мощности удвоятся до 70 000 пластин в месяц, а доля выручки перевалит за 10 %. Наконец, к концу 2026 года TSMC сможет ежемесячно упаковывать по методу CoWoS количество чипов, эквивалентное 90 000 кремниевых пластин. Итого, с 2022 по 2026 годы производительность компании в этой сфере будет увеличиваться ежегодно в среднем на 50 %, причём процесс продолжится и после 2026 года. Одно только предприятие в Тайнане теоретически могло бы ежемесячно обрабатывать по 50 000 кремниевых пластин в месяц. Скорее всего, профильными заказами оно в итоге будет загружено только частично, а остальные мощности выделят под работу с методами упаковки CPO и FoPLP. Скоро появятся чипы Nvidia с маркировкой «Сделано в Америке», хотя упаковывать их будут на Тайване
05.12.2024 [15:24],
Владимир Мироненко
Taiwan Semiconductor Manufacturing (TSMC) ведёт переговоры с Nvidia по поводу производства графических процессоров для ИИ-ускорителей с архитектурой Blackwell на своём новом заводе в Аризоне, пишет Reuters со ссылкой на информированные источники. По данным источников, TSMC уже готовится приступить к производству чипов Nvidia в начале следующего года. 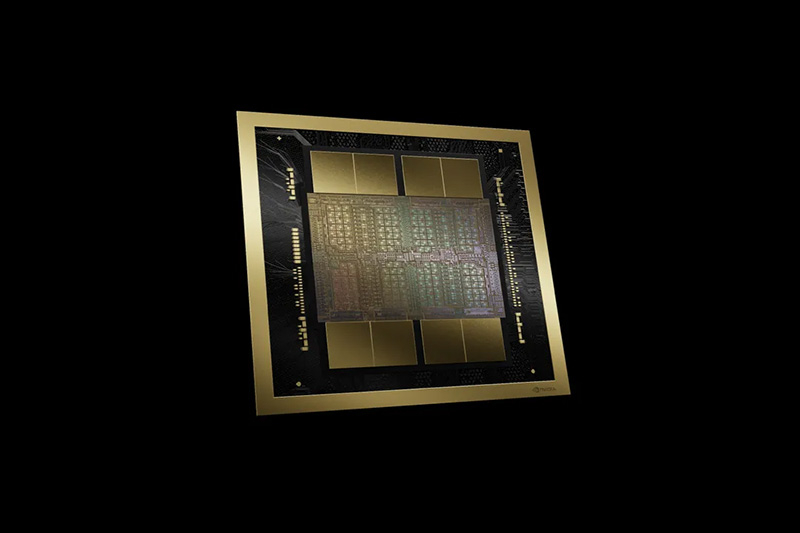
Источник изображения: Nvidia В настоящее время чипы для ускорителей Blackwell, представленных Nvidia в марте этого года, производятся на заводах TSMC на Тайване. Компания планирует значительно нарастить их выпуск, но имеющихся на Тайване производственных мощностей явно недостаточно, чтобы удовлетворить высокий спрос, подогреваемый ажиотажем вокруг ИИ-технологий. В случае заключения соглашения с Nvidia, у завода TSMC в Аризоне появится новый крупный клиент. По данным источников Reuters, в настоящее время на предприятии TSMC в Аризоне производятся чипы для Apple и готовится производство GPU для ускорителей AMD. Вместе с тем источники отметили, что, хотя TSMC планирует осуществлять front-end-процесс производства чипов Blackwell в Аризоне, их всё равно нужно будет отправлять на Тайвань для упаковки. Дело в том, что на заводе TSMC в Аризоне нет мощностей для упаковки чипов по передовой технологии TSMC CoWoS, используемой для ускорителей Blackwell. Остаётся только догадываться, насколько станут дороже выпускаемые в Аризоне чипы из-за транспортировки на Тайвань и обратно. TSMC продолжит расширять мощности по упаковке чипов методом CoWoS даже в 2026 году
21.10.2024 [06:40],
Алексей Разин
Для сегмента ускорителей вычислений, используемых в составе систем искусственного интеллекта, способность TSMC упаковывать достаточное количество чипов методом CoWoS имеет огромное значение, поскольку в случае с производством решений Nvidia остаётся «узким местом». Тайваньский производитель намерен активно расширять профильные мощности не только в следующем, но и в 2026 году. 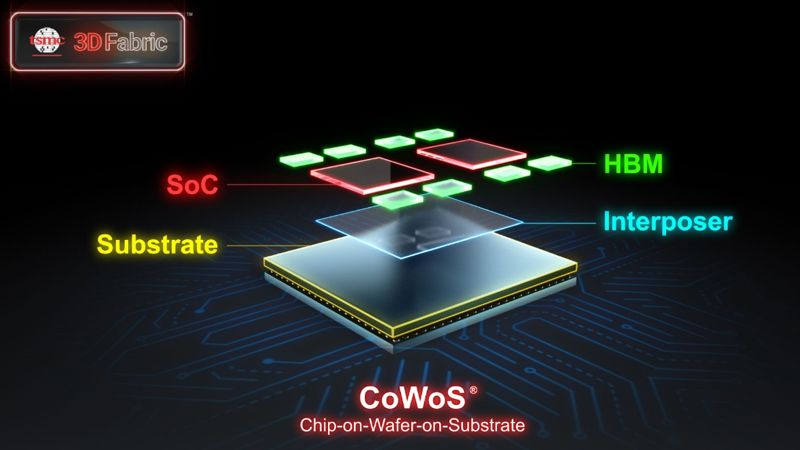
Источник изображения: TSMC По крайней мере, генеральный директор и председатель совета директоров TSMC Си-Си Вэй (C.C. Wei) пояснил, что в текущем году способности компании по упаковке чипов методом CoWoS вырастут более чем в два раза по сравнению с прошлым годом, и в следующем могут также удвоиться. Не исключено, по словам главы компании, что даже таких темпов экспансии не хватит для удовлетворения спроса на профильные услуги TSMC. Если говорить об экономике процесса, то сейчас TSMC получает не более 10 % выручки от оказания услуг по упаковке чипов, и в ближайшие пять лет данный сегмент будет расти быстрее прочих направлений деятельности компании. Пока ему не удаётся по норме прибыли достичь средних по всем сегментам показателей, но разница уже не так велика. Свою долю на мировом рынке услуг по упаковке чипов TSMC оценивает примерно в 30 %. По информации Money DJ, компания TSMC уже разместила заказы на оборудование, которое ей потребуется для упаковки чипов, сроком до 2026 года включительно. Если к концу текущего года TSMC сможет ежемесячно обрабатывать по 40 000 кремниевых пластин в эквивалентном выражении на направлении упаковки чипов методом CoWoS, то в следующем году объём удвоится до 80 000 штук в месяц. К 2026 году темпы экспансии могут замедлиться, расположившись в диапазоне от 100 до 120 тысяч пластин в месяц. Однако, при наличии спроса эти показатели легко могут вырасти до 140 или 150 тысяч пластин в месяц. Nvidia может поручить Intel упаковку чипов для передовых ИИ-ускорителей
05.08.2024 [12:06],
Алексей Разин
На минувшем квартальном отчётном мероприятии Intel на передний план вышли другие проблемы компании, но до этого руководство регулярно давало понять, что компания готова упаковывать чипы по заказам сторонних клиентов. Тайваньские СМИ теперь сообщают, что в условиях дефицита профильных мощностей TSMC к возможности сотрудничества с Intel присматривается Nvidia. 
Источник изображения: Nvidia В мае прошлого года, напомним, основатель Nvidia Дженсен Хуанг (Jensen Huang) похвалил современные техпроцессы Intel, а разговоры о возможности сотрудничества компаний начались ещё за год до того. Впрочем, новые слухи указывают на интерес Nvidia к услугам Intel именно в сфере упаковки чипов с использованием продвинутых методов. Компания TSMC обладает монопольным правом на использование упаковки CoWoS, которая нужна для выпуска ускорителей вычислений Nvidia актуальных поколений, но технологически этот метод очень близок к тем, что использует Intel. Соответственно, как полагают источники, после некоторой адаптации Intel могла бы наладить упаковку и тестирование чипов Nvidia для ускорителей вычислений. В целом, интерес к подобным услугам Intel проявляют Qualcomm, Microsoft, Cisco и AWS (Amazon). Представители Intel не раз говорили, что в этой сфере контракты с клиентами начинают приносить выручку гораздо быстрее, чем в сфере обработки кремниевых пластин, поэтому в развитии этого направления бизнеса процессорный гигант сильно заинтересован. По слухам, Intel уже получила от Microsoft заказ на производство чипов по технологии Intel 18A на сумму $15 млрд. Nvidia пыталась выбить у TSMC выделенную линию по 3D-упаковке ИИ-чипов, но не вышло
23.07.2024 [12:08],
Алексей Разин
В плане своей способности поставлять клиентам ускорители вычислений Nvidia зависит от TSMC не только с точки зрения обработки кремниевых пластин, но и на этапе компоновки чипов с использованием уникального метода пространственной упаковки CoWoS. Попытки руководства первой из компаний получить для этих нужд выделенные производственные мощности TSMC не увенчались успехом, если верить слухам. 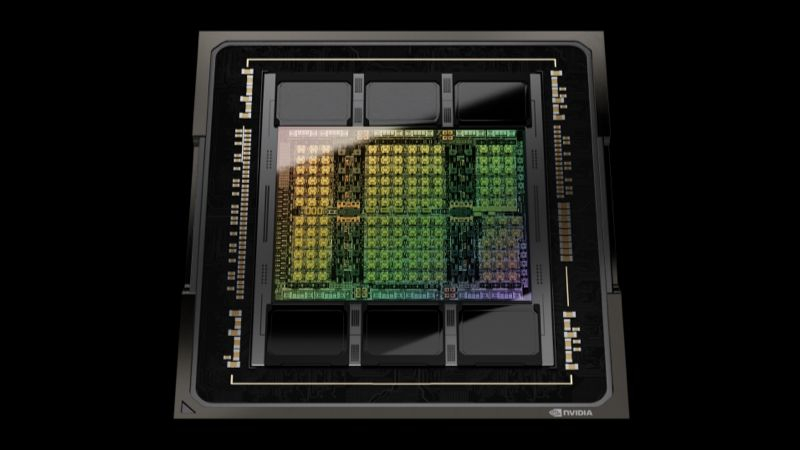
Источник изображения: Nvidia Данную информацию публикует ресурс Mirror Media, ссылаясь на подробности о программе визита основателя Nvidia Дженсена Хуанга (Jensen Huang) на Тайвань в июне этого года. По данным источников, тогда у него состоялась встреча не только с отошедшим от дел основателем TSMC Моррисом Чаном (Morris Chang), но и действующим руководителем компании Си-Си Вэем (C.C. Wei). Глава Nvidia в тот момент, если верить слухам, попросил у TSMC выделить под нужды его компании отдельную производственную линию, на которой будут упаковываться ИИ-чипы этой марки, но получил отказ от представителей тайваньского подрядчика. Исход переговоров создал некоторую напряжённость в отношениях между компаниями, как отмечают источники, но нынешний председатель совета директоров Си-Си Вэй сделал всё возможное, чтобы загладить последствия. На недавней квартальной конференции руководство TSMC признало, что компания не сможет удовлетворить спрос на выпуск компонентов для систем искусственного интеллекта как минимум до 2026 года. При этом тайваньский производитель до сих пор не может найти баланс спроса и предложения, но старается рационально определять размер необходимых капитальных затрат. По всей видимости, вложения в производственную линию для упаковки чипов Nvidia на данном этапе кажутся руководству TSMC нерациональными. Тем более, что норма прибыли в этой сфере услуг приближается к средней по компании, не обеспечивая каких-то впечатляющих преимуществ. Как отмечается, отказ TSMC был мотивирован возможными последствиями для отношений компании с другими клиентами, которые также захотели бы добиться определённых привилегий. Сохраняя равные для всех клиентов условия, TSMC может обеспечить более предсказуемую ситуацию с масштабированием производственных мощностей. В прошлом, как отмечают знакомые с практикой дел TSMC источники, эта компания предоставляла крупным клиентам определённые привилегии. Например, Apple в своё время попросила предоставить ей выделенные линии по выпуску чипов, и TSMC пошла на это, но в тот период тайваньский производитель сильно зависел от заказов Apple и не мог пренебрегать такой возможностью оптимальным образом загрузить свой конвейер. В случае с Nvidia ситуация заметно отличается. Как ожидается, TSMC не сможет покрыть потребности рынка в мощностях по упаковке чипов по методу CoWoS даже к концу следующего года, поскольку спрос будет расти опережающими темпами. Подобное положение на рынке, близкое к монопольному, позволяет TSMC более жёстко отстаивать свои интересы в переговорах с заказчиками. Это заметно даже по высказываниям Си-Си Вэя, который недавно признался, что хотел бы брать с той же Nvidia больше денег за услуги TSMC. TSMC поднимет цены на 3-нм чипы на 5 %, а передовая упаковка чипов CoWoS подорожает на 20 % в следующем году
17.06.2024 [09:10],
Алексей Разин
По данным тайваньского издания Commercial Times, мощности TSMC по обработке кремниевых пластин с использованием 3-нм техпроцесса почти полностью распределены по заказам среди семи крупнейших клиентов компании на весь следующий год. Упаковывать чипы по методу CoWoS компания в нужных количествах тоже не успевает, поэтому цены на эти услуги в следующем году поднимет на 10 или 20 %. 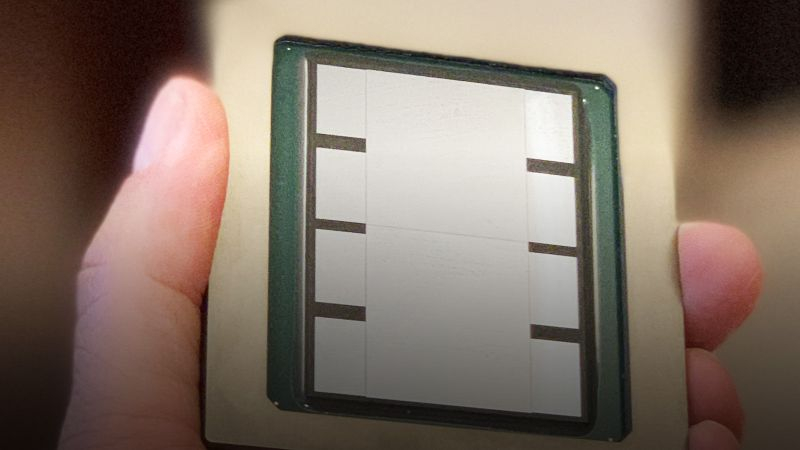
Источник изображения: TSMC Кроме того, обработка кремниевых пластин по 3-нм технологии будет обходиться клиентам TSMC на 5 % дороже со следующего года, как ожидают тайваньские источники. Руководство TSMC и Nvidia недавно обменялось мнениями по поводу возможного повышения цен на услуги первой из компаний, и вторая не стала противиться подобной инициативе, хотя публично тайваньский производитель обычно не комментирует вопросы, касающиеся взаимоотношений со своими клиентами. Потребность рынка в услугах TSMC по упаковке чипов по методу CoWoS тоже растёт опережающими темпами. При этом в третьем квартале компания введёт в строй дополнительные мощности, которые увеличат производительность профильных предприятий последовательно с 17 000 до 33 000 изделий в месяц, а к концу года показатель поднимется до 35 000 изделий в месяц. Даже этих усилий не хватит, чтобы в 2025 году покрыть весь спрос на такие услуги. Предполагается, что спрос выйдет на годовой объём в 600 000 чипов, а TSMC сможет упаковывать только 530 000 чипов в год. Капитальные затраты на расширение производства потребуют от TSMC повышения цен на свои услуги на 10–20 %. Предприятия по тестированию и упаковке чипов будут расширяться за пределы Тайваня
22.04.2024 [17:50],
Алексей Разин
Призывы к тайваньским компаниям создавать предприятия по выпуску чипов за пределами острова часто звучат от крупных клиентов и целых государств, но растущее значение в наше время обретает и сфера тестирования и упаковки чипов, которая должна развиваться синхронно. Эксперты считают, что экспансия профильных предприятий за пределами Тайваня будет неизбежной. 
Источник изображения: ASE Technology Как поясняет DigiTimes, возможности компании TSMC по тестированию и упаковке чипов с использованием передовой технологии CoWoS в текущем году должны удвоиться, но даже с учётом мощностей подрядчиков они не смогут покрыть потребности рынка. Компания ASE Technology обладает необходимым оборудованием и компетенциями, чтобы обеспечивать полный цикл тестирования и упаковки чипов по методу CoWoS 2.5D. Компания Amkor способна содействовать им лишь на определённых этапах технологического процесса, но в нынешней ситуации любая помощь очень важна. При этом для всей отрасли по упаковке чипов прошедший 2023 год характеризовался двузначным спадом показателей, а востребованным методом упаковки CoWoS владеют лишь немногие участники рынка, перечисленные в этом абзаце выше. Помимо высокого спроса на определённый вид услуг, участников рынка толкает к международной экспансии суровая геополитическая реальность, которая заставляет критически оценивать высокую степень концентрации профильных предприятий на Тайване. Поставщики оборудования считают, что основными направлениями экспансии станут Сингапур, Малайзия и Япония. Для тайваньских компаний, которые решатся на такую миграцию, при выборе её направления будет важен целый ряд факторов: поддержка правительства в виде субсидий, наличие квалифицированной рабочей силы, развитость цепочек поставок и логистики, наличие спроса со стороны местных клиентов, а главное — готовность инженерной инфраструктуры к появлению новых предприятий. Стабильность энерго- и водоснабжения будет иметь первостепенную важность в этом вопросе. Генеральный директор TSMC Си-Си Вэй (C.C. Wei) на недавнем отчётном квартальном мероприятии заявил, что занимающаяся упаковкой чипов компания Amkor намеревается построить своё предприятие в Аризоне в непосредственной близости от производственной площадки TSMC. Обеим компаниям предстоит вести работу по приведению своих операций в регионе в соответствие с требованиями местных клиентов. SK hynix и TSMC будут сотрудничать в рамках производства HBM4
19.04.2024 [08:25],
Алексей Разин
В конце этой рабочей недели южнокорейская компания SK hynix сообщила о подписании меморандума о взаимопонимании с тайваньской компанией TSMC в сфере сотрудничества в рамках производства памяти HBM следующего поколения, коей является HBM4. Корейская компания освоит её массовое производство в 2026 году, и это позволит ей сохранить лидерские позиции на этом рынке. 
Источник изображения: SK hynix По данным TrendForce, в этом году SK hynix сможет сохранить за собой 52,5 % рынка микросхем типа HBM, ещё 42,4 % достанутся Samsung Electronics, а Micron Technology будет довольствоваться оставшимися 5,1 %. В настоящее время SK hynix является крупнейшим поставщиком микросхем HBM3 для нужд Nvidia и собирается в ближайшие месяцы начать поставки более совершенной памяти типа HBM3E. Следующим этапом станет выпуск HBM4, который начнётся ориентировочно в 2026 году, и сейчас SK hynix пытается заручиться поддержкой TSMC в этом вопросе. Дело в том, что TSMC остаётся единственной компанией, способной упаковывать память HBM и ускорители вычислений Nvidia по методу CoWoS, а потому SK hynix в эволюции своей памяти зависит от тайваньского партнёра. Из выделенных на текущий год капитальных затрат в диапазоне от $28 до $32 млрд компания TSMC намеревается до десяти процентов потратить на расширение мощностей по упаковке чипов и памяти. Именно их нехватка считается одной из причин дефицита ускорителей вычислений Nvidia для систем искусственного интеллекта. В прошлом году на долю HBM приходилось не более 8,4 % выручки в сегменте DRAM, но по итогам текущего эта доля вырастет до 20,1 %. Выход Nvidia Blackwell увеличит спрос на передовую упаковку чипов TSMC CoWoS более чем на 150 % в 2024 году
16.04.2024 [18:32],
Павел Котов
В этом году Nvidia выпустит семейство ускорителей вычислений нового поколения Blackwell, в котором будут представлены решения как с одними лишь графическими процессорами, например B100 и B200, так и решения, сочетающие графический процессор и центральный Arm-процессор собственной разработки — Blackwell GB200. Выход новых чипов Nvidia значительно увеличит спрос на упаковку чипов по передовой технологии TSMC CoWoS, уверены аналитики TrendForce. 
Источник изображения: nvidia.com Если на долю ускорителей GH200 приходились лишь 5 % поставок высокопроизводительных GPU Nvidia, то с GB200 этот показатель к 2025 году вырастет до 40–50 %. Nvidia планирует наладить выпуск GB200 и B100 во второй половине года, для упаковки чипов потребуется сложная и высокоточная технология CoWoS-L, которая сделает процесс тестирования трудоёмким. Потребуется дополнительное время для оптимизации серии Blackwell для серверных систем искусственного интеллекта в таких аспектах как сетевое соединение и показатели охлаждения. Как ожидается, производство продуктов GB200 и B100 в значительных объемах начнётся не раньше IV квартала 2024 или I квартала 2025 года. Выпуск ускорителей GB200, B100 и B200 потребует увеличения ёмкости линий по упаковке чипов CoWoS. Ожидается, что TSMC к концу года увеличит их производительность до почти 40 тыс. чипов в месяц — это рост на 150 % по сравнению с прошлым годом. К 2025 году запланированная общая мощность может почти удвоиться, при этом, как ожидается, спрос со стороны Nvidia составит более половины от этой мощности. Другие поставщики, такие как Amkor и Intel, в настоящее время сосредоточены на технологии CoWoS-S, в первую очередь ориентированной на H-серию Nvidia. 
Источник изображения: trendforce.com Аналитики TrendForce также определили три основные тенденции развития направления памяти HBM для продуктов Nvidia и AMD после 2024 года. Во-первых, ожидается переход от HBM3 к HBM3e. Во второй половине 2024 года Nvidia начнёт наращивать поставки ускорителей H200, оснащённых HBM3e, которые заменят H100 в качестве основного продукта. Далее последуют модели GB200 и B100 также с HBM3e. AMD же к концу года выпустит новый ускоритель MI350, который могут предварять промежуточные модели, такие как MI32x, направленные на конкуренцию с H200 — все они получат HBM3e. Во-вторых ёмкость HBM будет расти. Сегодня используются преимущественно ускорители Nvidia H100 с 80 Гбайт памяти — к концу 2024 года будут уже 192–288 Гбайт. Ускоритель AMD MI300A получил 128 Гбайт памяти, но и «красные» нарастят ёмкость до 288 Гбайт. В-третьих, память HBM3e сменит конфигурацию со стеков 8Hi (8 кристаллов DRAM уложенных друг на друга) до 12Hi. Модели Nvidia B100 и GB200 в настоящее время оснащаются HBM3e 8Hi ёмкостью 192 Гбайт, а к 2025 году модель B200 получит HBM3e 12Hi ёмкостью 288 Гбайт. Ускоритель AMD MI350, который появится к концу этого года, и ожидаемая в 2025 году серия MI375, как ожидается, получат HBM3e 12Hi также объёмом 288 Гбайт. TSMC продолжит наращивать мощности по упаковке чипов и предложит технологию нового поколения
20.01.2024 [08:29],
Алексей Разин
В июле прошлого года руководство TSMC пообещало нарастить мощности по упаковке чипов методом CoWoS в два раза к концу текущего года, тем самым рассчитывая победить дефицит подобных услуг, порождённый ростом спроса на ускорители для систем искусственного интеллекта. Теперь TSMC признаётся, что наращивать мощности придётся и в следующем году, но при этом компания готовит новое поколение упаковки CoWoS. 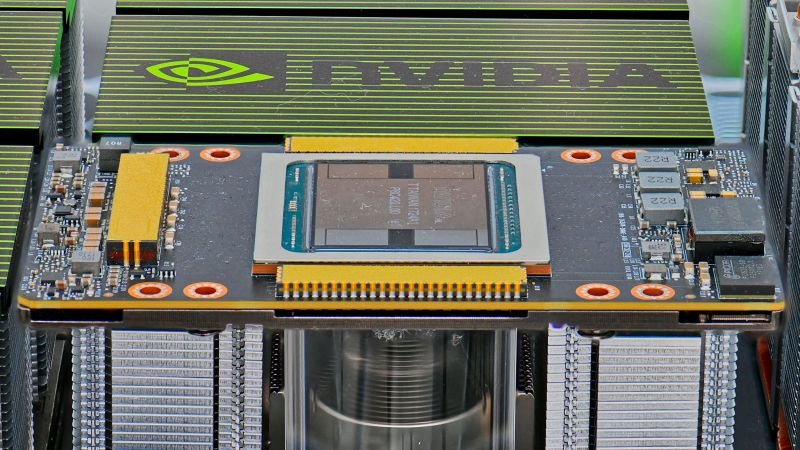
Источник изображения: NVIDIA Напомним, именно упаковку CoWoS используют ускорители вычислений NVIDIA, используемые в составе многих систем искусственного интеллекта. По сути, дефицит таких ускорителей во многом порождён ограниченностью возможностей TSMC по упаковке и тестированию чипов с использованием данной технологии. Компания делает всё возможное для устранения дефицита, хотя с точки зрения величины капитальных затрат на текущий год изменения в этой не прослеживаются. На этой неделе стало известно, что в этом году TSMC потратит от $28 до $32 млрд на расширение производственных мощностей и освоение новых технологий, причём на упаковку будет потрачено в лучшем случае не более 10 % этой суммы. Данные затраты примерно сопоставимы с прошлогодними, из чего можно сделать вывод, что экспансия профильных мощностей будет происходить линейно, без резких скачков в производительности. Генеральный директор TSMC Си-Си Вэй (C.C. Wei) на квартальной отчётной конференции признал, что спрос на услуги в сфере упаковки чипов очень высок. Ситуация по-прежнему такова, что TSMC не в силах удовлетворить спрос со стороны клиентов. «Это состояние, возможно, продлится вплоть до следующего года. Впрочем, мы очень активно работаем над тем, чтобы увеличить мощности. В этом году, например, мы их удваиваем, но этого всё равно недостаточно, поэтому мы продолжим их увеличивать и в следующем году», — заявил глава TSMC, добавив, что компания вкладывает средства в сопутствующие технологии на протяжении более 10 лет. По его оценкам, в ближайшие пять лет сегмент CoWoS будет расти более чем на 50 % ежегодно в среднем. TSMC вполне по силам покрыть весь спрос со стороны клиентов. Глава компании отказался отвечать на вопрос о темпах роста упаковочных мощностей TSMC в следующем году. Говоря о крупном клиенте, в котором угадывается NVIDIA, руководитель TSMC заявил об усердной работе над обеспечением его потребностей адекватными производственными мощностями, но до 100-процентного решения проблемы пока далеко. Для этого клиента TSMC уже разрабатывает новое поколение упаковки CoWoS, и её характеристиками уже впечатлён не только данный клиент, но и все прочие, поэтому компания не сомневается в необходимости дальнейшего увеличения профильных мощностей. TSMC ускорила расширение мощностей по упаковке чипов, необходимых для выпуска ИИ-чипов NVIDIA
26.09.2023 [18:36],
Алексей Разин
Представители TSMC недавно дали понять, что в части услуг по упаковке чипов методом CoWoS компания сейчас способна удовлетворять потребности клиентов от силы на 80 %, и на фоне резко растущего спроса устранить дефицит удастся лишь к концу следующего года. По данным тайваньских СМИ, сейчас TSMC вынуждена расширять профильные мощности быстрее, чем планировала изначально. 
Источник изображения: NVIDIA Издание Taiwan Economic Daily поясняет, что сперва TSMC рассчитывала увеличить производительность профильных линий с 12 000 кремниевых пластин в месяц до 15 000 или 20 000 пластин в месяц, завершив этот этап расширения к концу первого квартала следующего года. Теперь возникла потребность поднять производительность линий по упаковке чипов методом CoWoS ещё примерно на 30 %, до 25 000 или 30 000 пластин в месяц. По крайней мере, к концу второго квартала TSMC рассчитывает получить от производителей оборудования всё необходимое, чтобы уже во второй половине следующего года выйти на новый объём ежемесячной упаковки чипов. В целом, как отмечалось ранее, TSMC готова к концу следующего года удвоить профильные мощности по сравнению с текущим уровнем. NVIDIA сейчас получает около 60 % квот на данный вид услуг, как поясняют тайваньские источники, оставаясь крупнейшим клиентом TSMC. При этом спрос на упаковку методом CoWoS растёт и со стороны других разработчиков, включая AMD, Broadcom и Amazon, поэтому TSMC вынуждена увеличивать производственные мощности не только по прихоти NVIDIA. Поставщики профильного оборудования для упаковки чипов с воодушевлением смотрят на перспективы роста своей выручки вплоть до середины следующего года, поскольку заказами со стороны TSMC они как раз обеспечены до этого времени. Сейчас именно способность TSMC упаковывать ускорители вычислений A100 и H100 в известной степени ограничивает возможности NVIDIA по увеличению объёмов их поставок на фоне бума систем искусственного интеллекта. Руководство NVIDIA готово привлекать новых партнёров к решению этой проблемы, но «перепрыгнуть» через TSMC ему всё равно не удастся, поскольку технология производства указанных чипов NVIDIA подразумевает использование только упаковки CoWoS в исполнении конкретного тайваньского подрядчика. |