
|
Опрос
|
реклама
Быстрый переход
Технически Intel готова упаковывать чипы для клиентов TSMC
31.03.2025 [04:59],
Алексей Разин
Спрос на ускорители вычислений Nvidia растёт опережающими темпами, и одной из причин непропорционального увеличения предложения являются проблемы с упаковкой чипов на мощностях TSMC. Представители Intel утверждают, что решения клиентов TSMC с упаковкой типа CoWoS можно без проблем перенести на фирменную технологию Foveros. 
Источник изображения: Intel Об этом в переписке с группой репортёров, как сообщает EE Times, заявил недавно Марк Гарднер (Mark Gardner), вице-президент Intel Foundry по упаковке и тестированию: «Что касается Foveros, то она способна обеспечить бесшовный переход. Мы взяли продукты, которые используют технологию CoWoS, и прямым образом портировали их без каких-либо изменений в дизайне на технологию Foveros». Если учесть, что чипы для ускорителей вычислений Nvidia используют технологию упаковки CoWoS, есть вероятность их успешного переноса на конвейер Intel Foundry — хотя бы на стадии упаковки и тестирования. Важно, что тем самым Nvidia быстрее исключит транспортировку кремниевых пластин на Тайвань при условии их предварительной обработки в США на предприятии TSMC в Аризоне. То есть, политические факторы могут сыграть Intel на руку сильнее, чем технологические или экономические. По словам представителя Intel, компания с прошлого года выпускает решения, которые изначально разрабатывались под CoWoS, но позже были приспособлены под фирменные технологии EMIB или Foveros. Для потенциальных клиентов это важно, как добавил Гарднер, поскольку это не вынуждает их долго ждать адаптации дизайна своих компонентов под возможности нового подрядчика. Внутри Intel есть команда специалистов, которые взаимодействуют с TSMC, Samsung, SK hynix и Micron в вопросах унификации правил дизайна, позволяющих использовать интерфейсы в сложной пространственной компоновке чипов с минимальными изменениями при переносе с одного конвейера на другой. Как признался Гарднер, компания Intel разработала технологию упаковки EMIB-T с использованием межслойных соединений, которая позволяет создавать чипы с трёхмерной компоновкой и высокой пропускной способностью интерфейсов без высокого энергопотребления. Клиенты Intel уже готовы использовать эту технологию в последующие год или два. Впрочем, имена своих клиентов контрактное подразделение Intel до сих пор раскрывает неохотно, и в конкретной беседе с представителями EE Times упоминались только Mediatek и AWS (Amazon). Эксперты TechInsights утверждают, что Intel не особо продвигает свои возможности по контрактной упаковке чипов, тогда как компания располагает не только передовыми технологиями в этой сфере, но и свободными производственными мощностями. Траектория развития полупроводниковой отрасли такова, что на нынешнем этапе упаковке важно уделять внимание, поскольку она позволяет эффективно повышать производительность компонентов без видимого прогресса в литографии. Intel открыла в Нью-Мексико завод Fab 9, который будет массово выпускать чипы с передовой 3D-упаковкой
25.01.2024 [10:27],
Павел Котов
Intel торжественно открыла в городе Рио-Ранчо (шт. Нью-Мексико, США) завод Fab 9 — предприятие запущено в рамках инвестиционной программы с бюджетом $3,5 млрд, направленной на организацию производства с использованием передовых решений в области упаковки чипов, в том числе технологии 3D-упаковки Intel Foveros, предлагающей гибкие возможности компоновки чиплетов с оптимизацией по мощности, производительности и стоимости. 
Источник изображений: intc.com Расположенные в Рио-Ранчо заводы Fab 9 и Fab 11x составляют первую действующую площадку для массового производства чипов с передовой 3D-упаковкой Intel, образуя сквозной производственный процесс, направленный на формирование эффективной цепочки поставок. Полупроводниковая промышленность вступает в эпоху гетерогенных решений, предусматривающей сочетание нескольких чиплетов в одном корпусе с передовыми технологиями, такими как Foveros и EMIB (Embedded Multi-die Interconnect Bridge) — они представляют эффективный способ достичь 1 трлн транзисторов на чипе, продлевая действие закона Мура в следующее десятилетие. 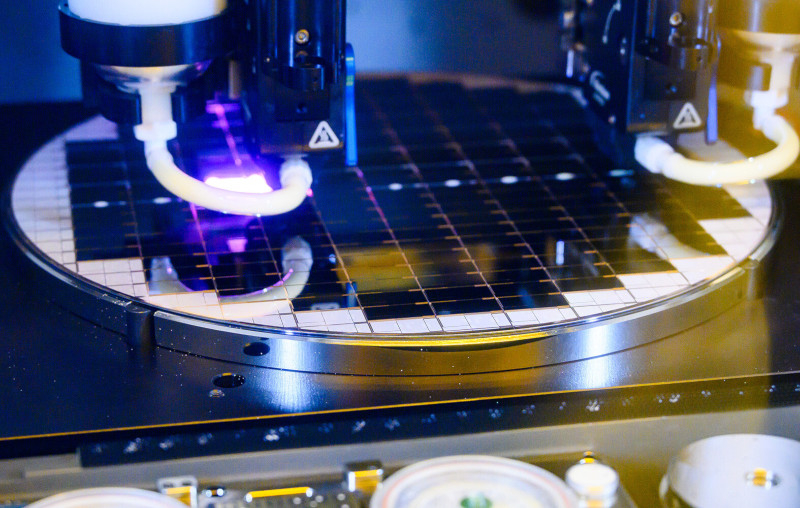 Технология 3D-упаковки Intel Foveros — первое в своём роде решение, позволяющее создавать процессоры, тайлы в которых располагаются не рядом, а вертикально. Это поможет Intel и её заказчикам комбинировать вычислительные модули для оптимизации затрат и энергоэффективности. Инвестиционная программа Intel в Рио-Ранчо с бюджетом $3,5 млрд позволила создать 3000 рабочих мест на строительстве и ещё 3500 — по всему штату. Intel собирается расположить в Малайзии крупнейшее предприятие по упаковке чипов с использованием трёхмерной компоновки
23.08.2023 [07:26],
Алексей Разин
События последних двух лет почти приучили нас к мысли, что Intel стремится размещать новые предприятия в США и Европе, повышая технологический суверенитет регионов, но процессорный гигант не собирается ограничиваться данными географическими направлениями при экспансии своих производственных мощностей. В Малайзии будет построено крупнейшее предприятие компании, специализирующееся на трёхмерной упаковке чипов. 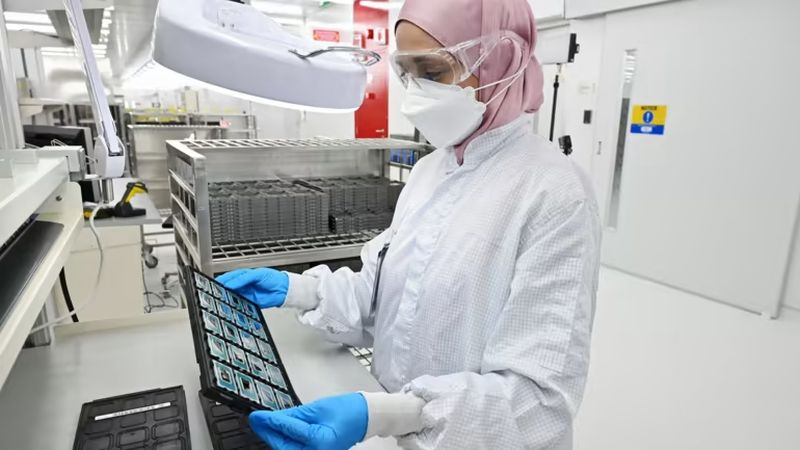
Источник изображения: Intel Об этом в интервью Nikkei Asian Review заявил корпоративный вице-президент Intel Робин Мартин (Robin Martin), отвечающий за снабжение предприятий и их операции. Сейчас компания строит в Малайзии своё первое предприятие по упаковке чипов с использованием трёхмерных методов компоновки, включая технологию Foveros. По соседству появится ещё одно предприятие по тестированию и упаковке чипов с использованием более традиционных технологий. В общей сложности Intel собирается потратить на расширение своего бизнеса в Малайзии $7 млрд. Когда новые предприятия в Малайзии будут введены в строй, не уточняется, но к 2025 году Intel собирается в четыре раза увеличить свои мощности по упаковке чипов с использованием новейших компоновочных решений. Спрос на подобные услуги подогревается сегментом ускорителей вычислений, и Intel готова обслуживать не только собственные потребности, но и сторонних клиентов, которые даже не заказывают ей выпуск соответствующих кристаллов. По оценкам Yole Intelligence, рынок услуг по упаковке чипов с использованием передовых технологий в прошлом году достиг ёмкости в $44,3 млрд, а к 2028 году он вырастет до $78,6 млрд, увеличиваясь в среднем на 10,6 % ежегодно. В настоящее время крупнейшие предприятия Intel по упаковке чипов с использованием передовых методов расположены в Орегоне и Нью-Мексико на территории США. По мнению представителей компании, появление таких предприятий в других точках планеты позволит привлечь больше сторонних клиентов к данным услугам. В Малайзии уже функционирует одно из крупнейших предприятий Intel по тестированию и упаковке чипов, которое обеспечивает взаимозаменяемость с аналогичными предприятиями в Китае и Вьетнаме. Численность персонала Intel в Малайзии достигает 15 000 человек, из них 6000 заняты в центре по разработке чипов. Крупнейший исследовательский центр Intel за пределами США при этом расположен в Индии, он обеспечивает работой 14 000 человек. В ближайшие годы дополнительные мощности по тестированию и упаковке чипов появятся в Италии и Польше. |